提率:善仁新材的这一无压低温技术提高了生产效率,从传统银烧结技术每小时只能生产约30个产品上升至现在的每小时3000个。现在,凭借这一新的银烧结材料,第三代半导体封装得以实现高产能,高可靠性的产品。
善仁新材相继开发出来180度无压烧结银,170度无压烧结银,160度无压烧结银,不停的挑战无压烧结银的烧结温度,从相关资料报道和机构认证,善仁新材新开发的AS9316纳米银膏,烧结温度只有160度,了烧结低温的先河。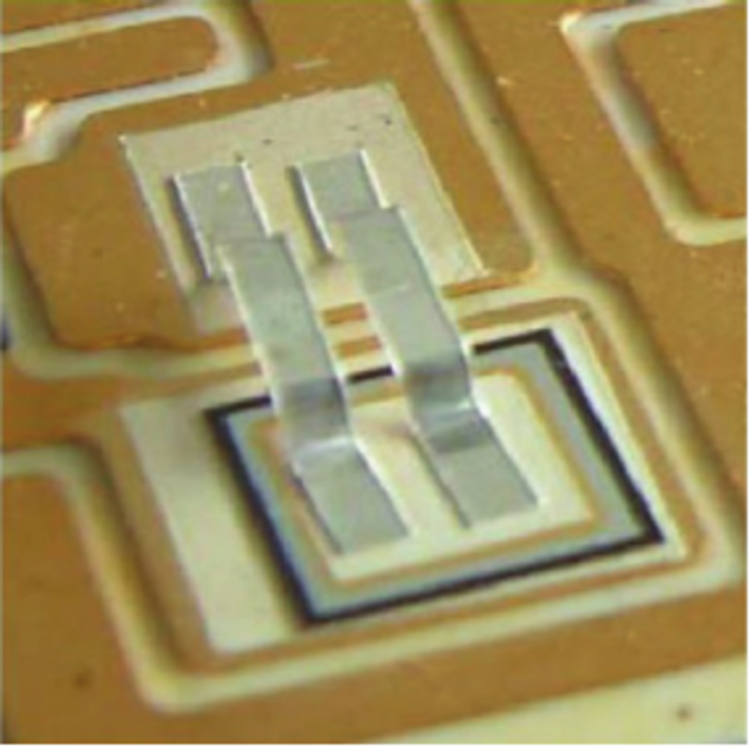
为了验证此策略,使用1200V/400A车用SiC功率模块的低应力封装工艺,此器件的烧结面积4.4 mm×4.0 mm,钼片厚度为1.5 mm,氧化铝衬底基板的厚度为1.2 mm。 两侧基板均采用AS9330低温无压银烧结技术以实现器件和钼片的互连,烧结后形成器件-基板组件和钼片-基板组件结构连接,烧结后两组组件的连接使用传统的高温焊料 Pb92.5Sn5Ag2.5。
联系我时,请说是在黄页88网厦门导电银胶栏目上看到的,谢谢!











